


반도체공학에서는 서로 다른 재료가 만났을 때 'contact'이라고 표현한다.
Al-n, Al-Polysilicon, Al-p 등등
ndiffusion을 통해서 polysilicon을 통해서 혹은 Metal 자체가 전류를 전달한다.

전류 수송 능력이 있다는 것은 저항성이 존재한다는 것과 같은 말이다.
일반적으로 사용 : 알루미늄, 티타늄, 텅스텐, 구리 9 자주 사용되지 않는 : 니켈, 백금, 팔라듐
금 : 실리콘의 급속 확산기, 티타늄 또는 텅스텐이 포함된 다층 샌드위치, 칩 패키징으로 제한됨.
알루미늄 (일반 재료) : 비교적 저렴, 실리콘에 접착, 저 저항 (2.7 uohm-cm)
구리 (고급 재료) : 더 나은 저항률 (1.7 uohm-cm), 큰 확산 계수
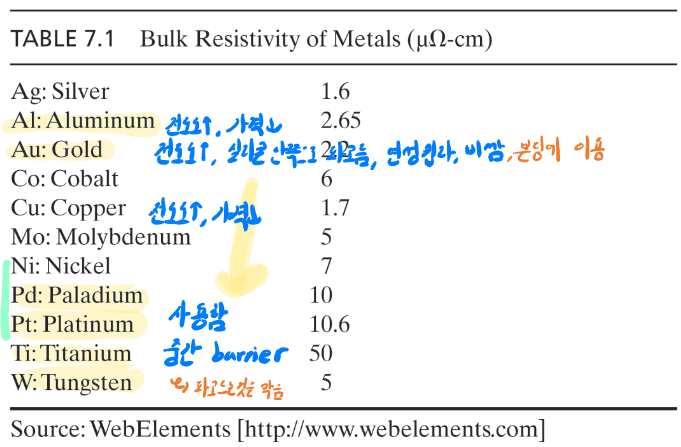
알루미늄과 구리는 전도도가 높지만 가격이 낮기 때문에 자주 사용되며
금은 전도도가 높고 연성하기 좋기 때문에 좋은 재료지만 가격이 비싸고 실리콘 안쪽으로 파고드는 단점이 있다.
Titanium은 중간 barrier로서 사용한다.

(a) Ideal Ohmic Contact
(b) Rectifying Contact: Metal과 실리콘의 contact만으로 junction을 이룬다.==> 샤키 다이오드
다이오드의 정류 작용을 할 수 있다
(c) Ohmic contact으로 실제로 관찰되는 non linear 한 형태이다.


금속과 맞는 '궁합'이 있다
알루미늄의 경우에는 n 도핑 기판과 접합하면 샤키 접합을 일으킨다.
p기판과 접합하면 ohmic 컨택
n+로 강하게 도핑하면 터널링 junction을 일으켜
터널링 이후에 metal contact이 이뤄지는데 non ideal 커브를 보인다.


알루미늄과 실리콘을 alloy 하면 녹는점을 낮출 수 있다.


Eutectic 온도보다 높아지면 Al이 흘러내릴 수 있는데 이를 'aluminum spiking'이라고 부른다.
short를 일으켜서 수명을 단축시킬 수 있기 때문에 Barrier material을 이용하여 침투를 막기도 한다.
접합부에 녹는점이 낮아져서 생기는 현상이라고 생각하면 된다.

열처리 온도가 높을수록 contact 저항이 낮아진다.
적절한 열처리 온도가 존재한다.
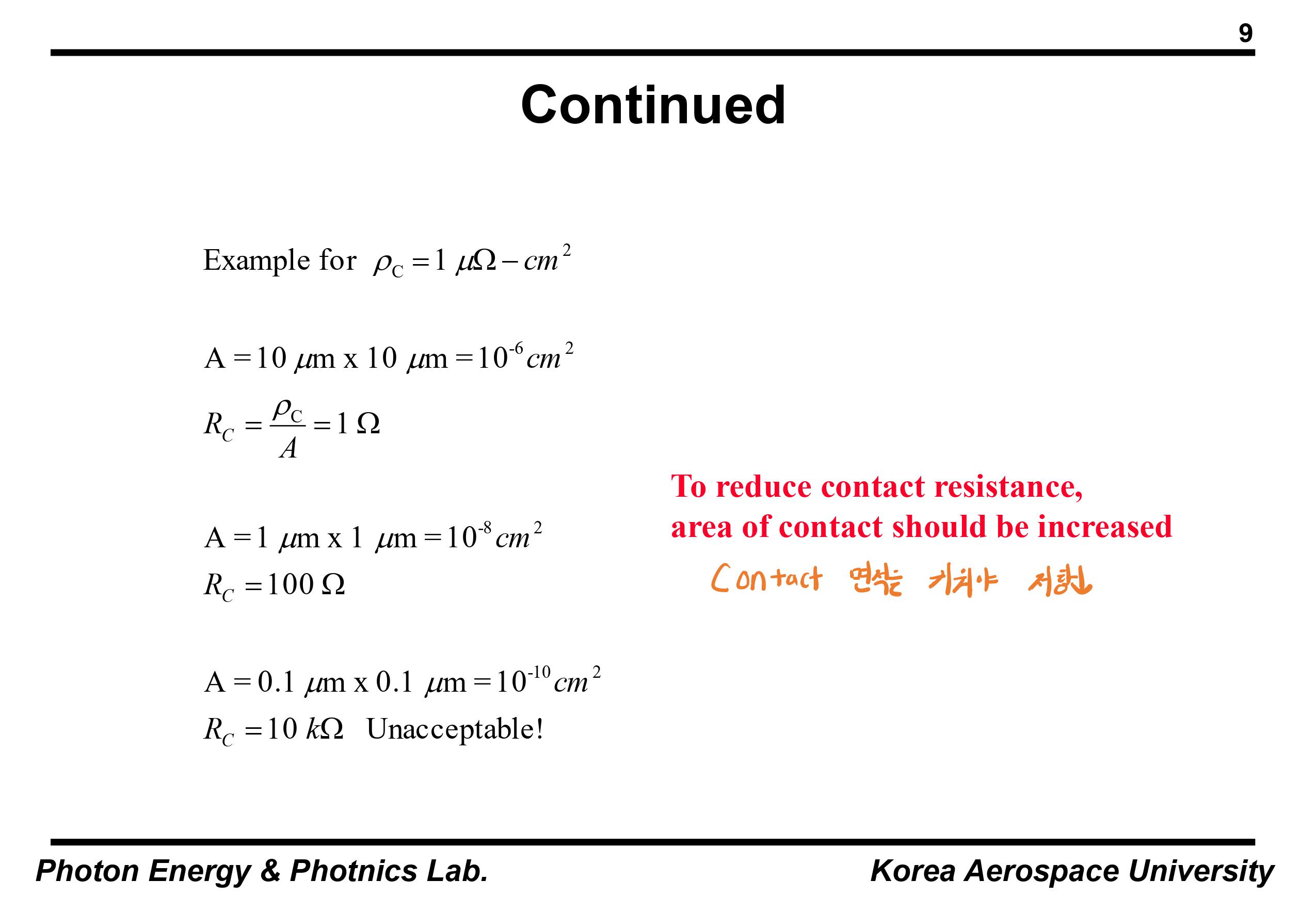
contact 면적을 키우면 저항을 낮출 수 있다.

작은 구멍을 여러 개 뚫는 것이 contact에 유리하다.

Electro migration은 전류로 인해 metal이 흘러가는 현상으로 라인이 끊어질 수 있다.
과다 전류가 일정한 방향으로 흘러갈 때 관찰된다. 즉, DC current에서 관찰되는 것이다.

MTTF(Mean Time To Failure)는 와이어가 끊기는데 걸리는 평균시간이다.
migration이 일어나는데 필요한 에너지가 크면 클수록 평균시간이 늘어나고
흐르는 전류가 많을수록 짧아진다.
주로 전원부에서 많이 발생한다.

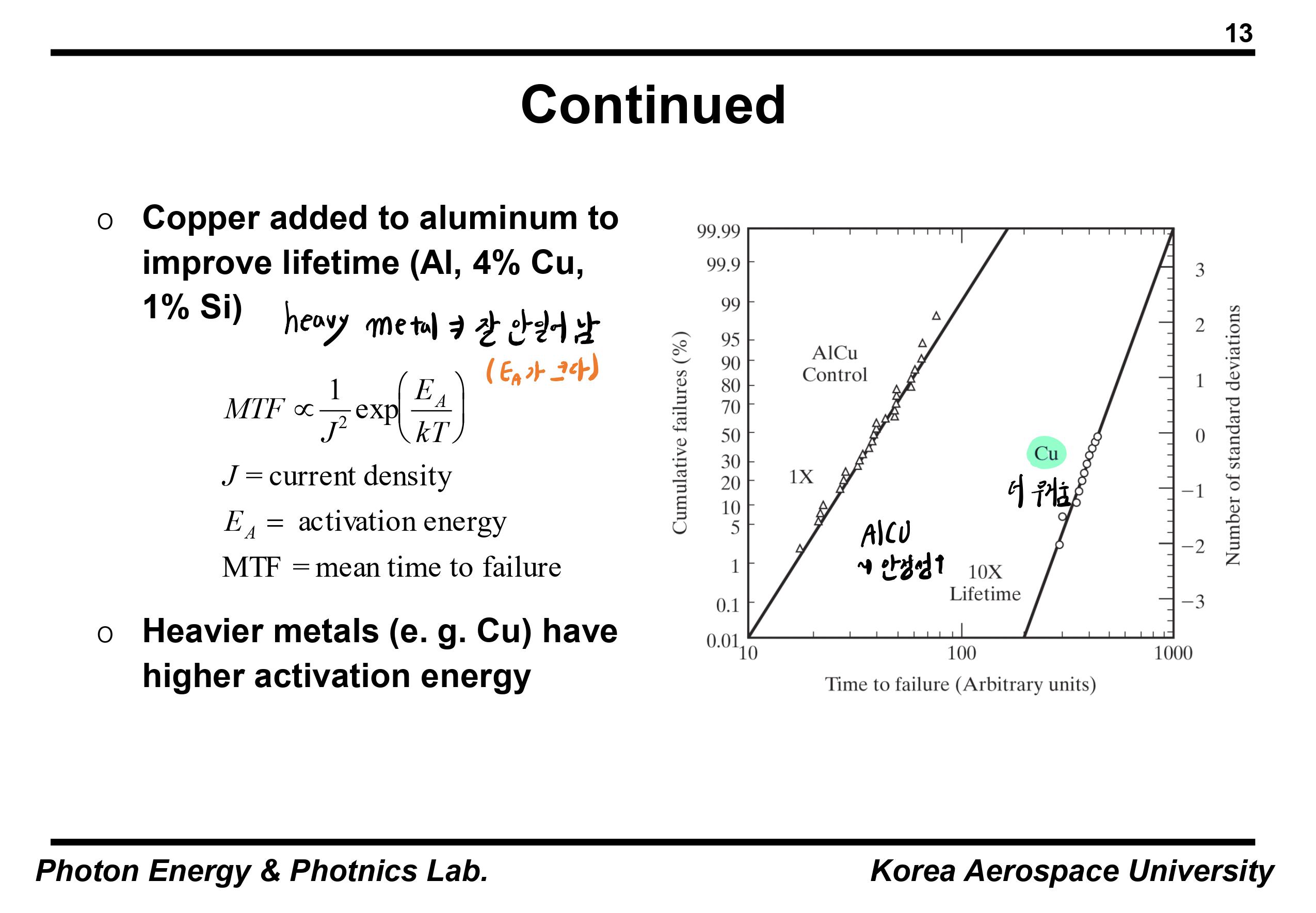
heavy metal일수록 activation energy가 높기 때문에 electro migration 현상은 잘 일어나지 않는다.

diffusion channel이 생성되는데 원하지 않는 기생 커패시터와 다이오드가 생성된다.

diffusion 채널을 interconnection으로 사용하면 회로를 더 간단하게 만들 수 있다.

연결된 채널로 전자를 운송함으로 인해서 공정을 생략하고 다수의 컨택 공정을 생략할 수 있다.
하나의 동일한 single diffusion line으로 연결할 수 있다.
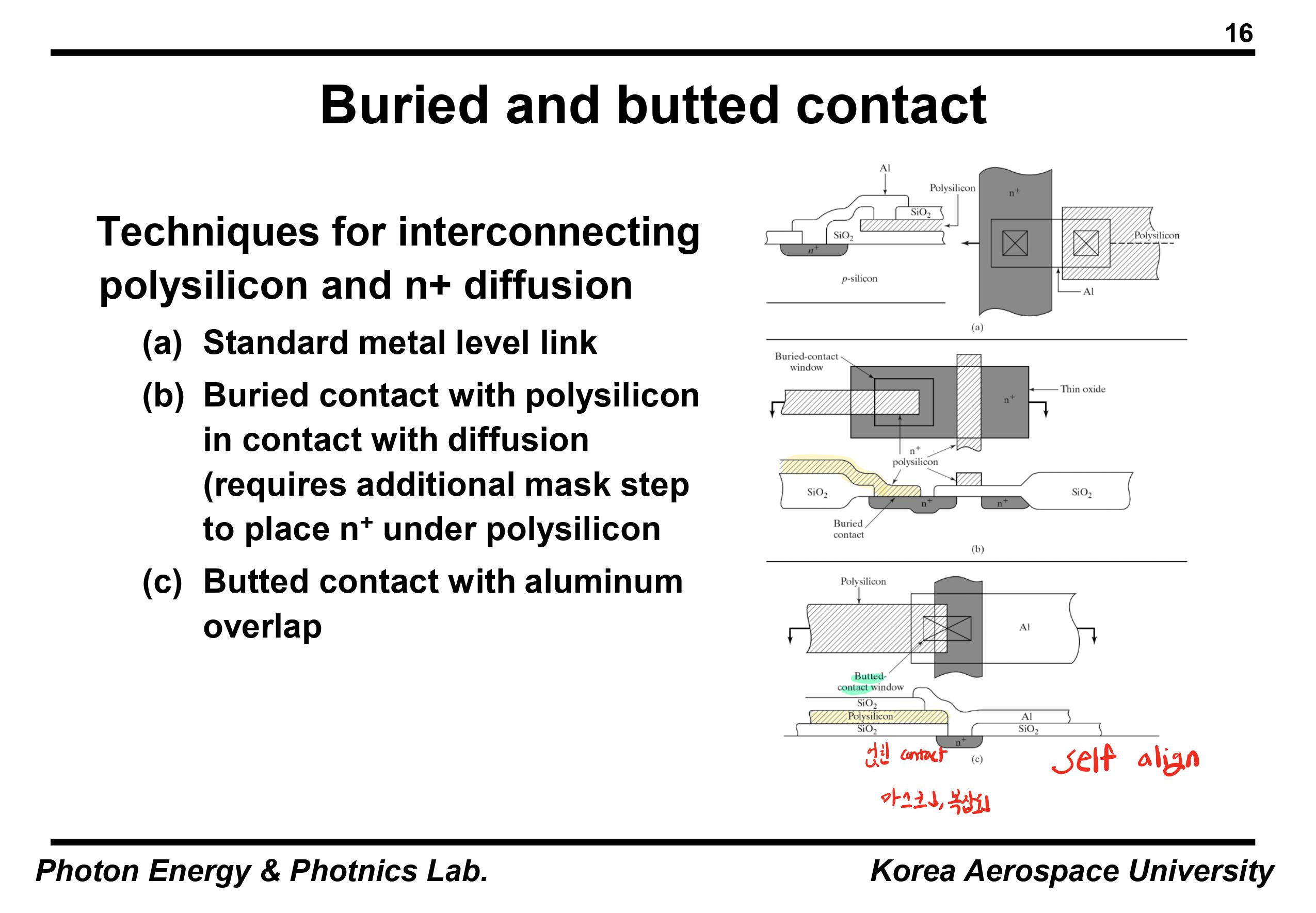
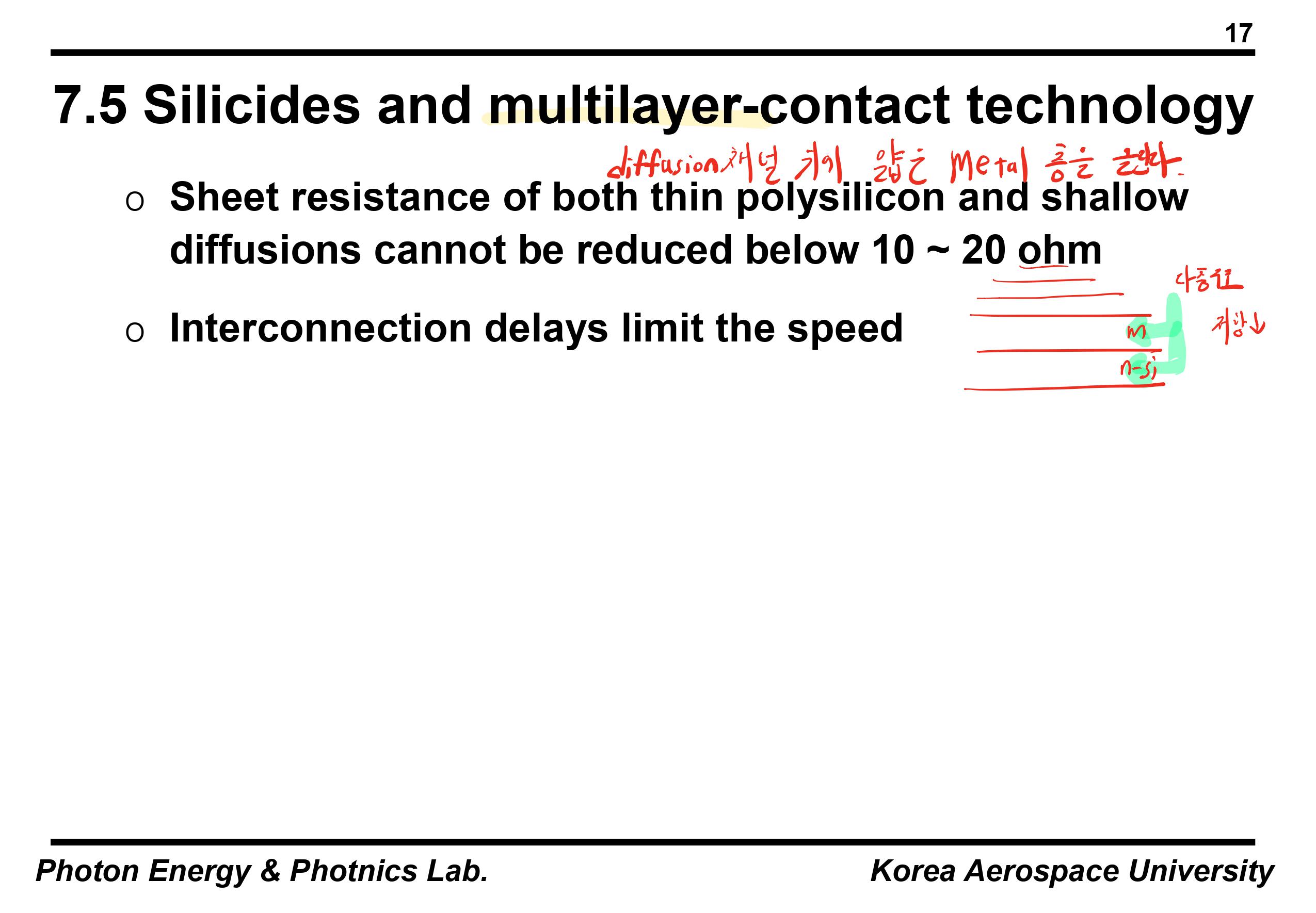



salicide는 특별한 lithography 공정 없이 self-align 공정이다.
SiO2도포 후에 에칭 하는데 상대적으로 두꺼운 부분이 Oxide spacer로 남는다.
그 이후에 metal을 alloy를 형성하는데 spacer 부분을 제외하고 형성된다.
salicide(Self-Aligned Silicides)
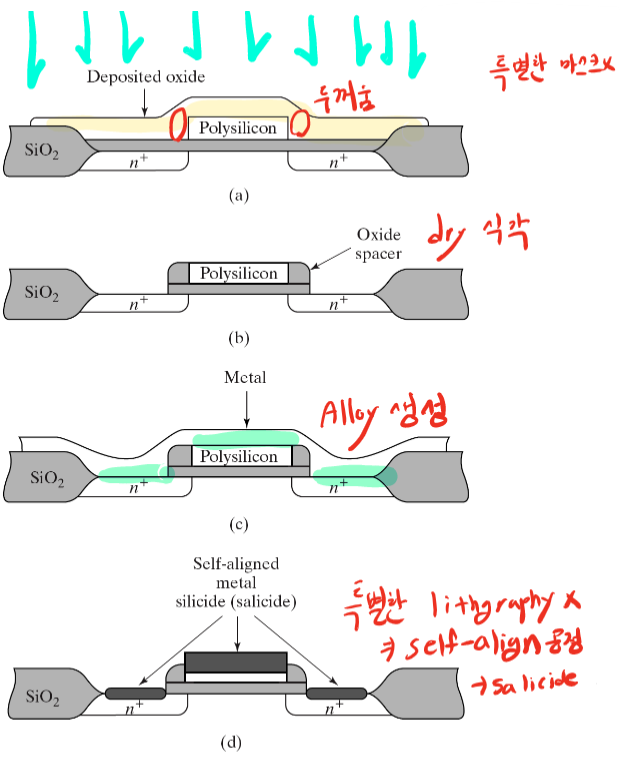

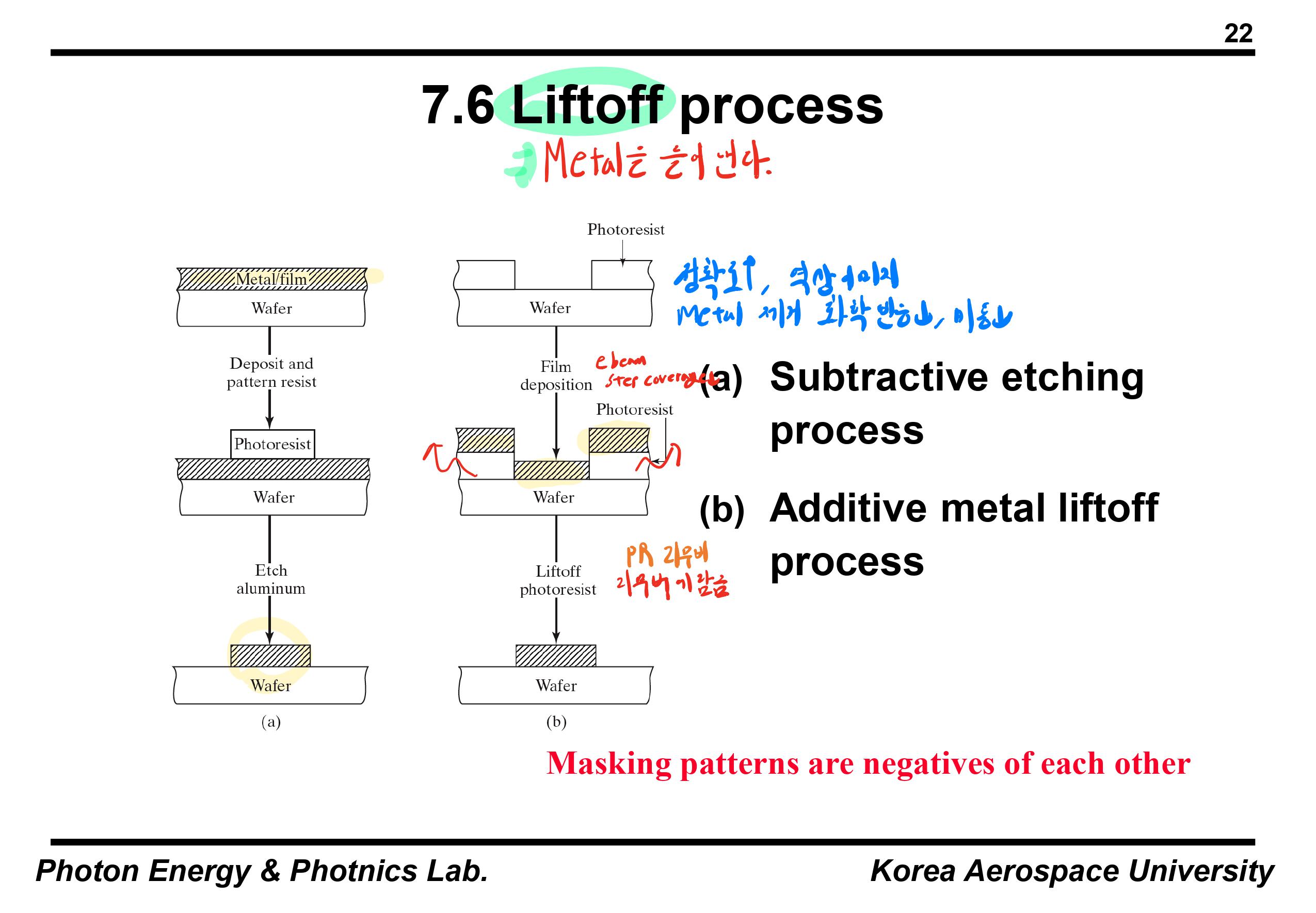
Liftoff는 metal을 들어내는 공정이다. 보통 에칭을 통해 들어내지만
미리 PR을 도포하고 metal을 성막 한 후에 PR 리무버에 담아서 PR과 함께 Metal 부분을 날려버릴 수 있다.
역상 이미지가 생긴다.

많은 공정을 진행하기 위해서 평탄화가 필수다.

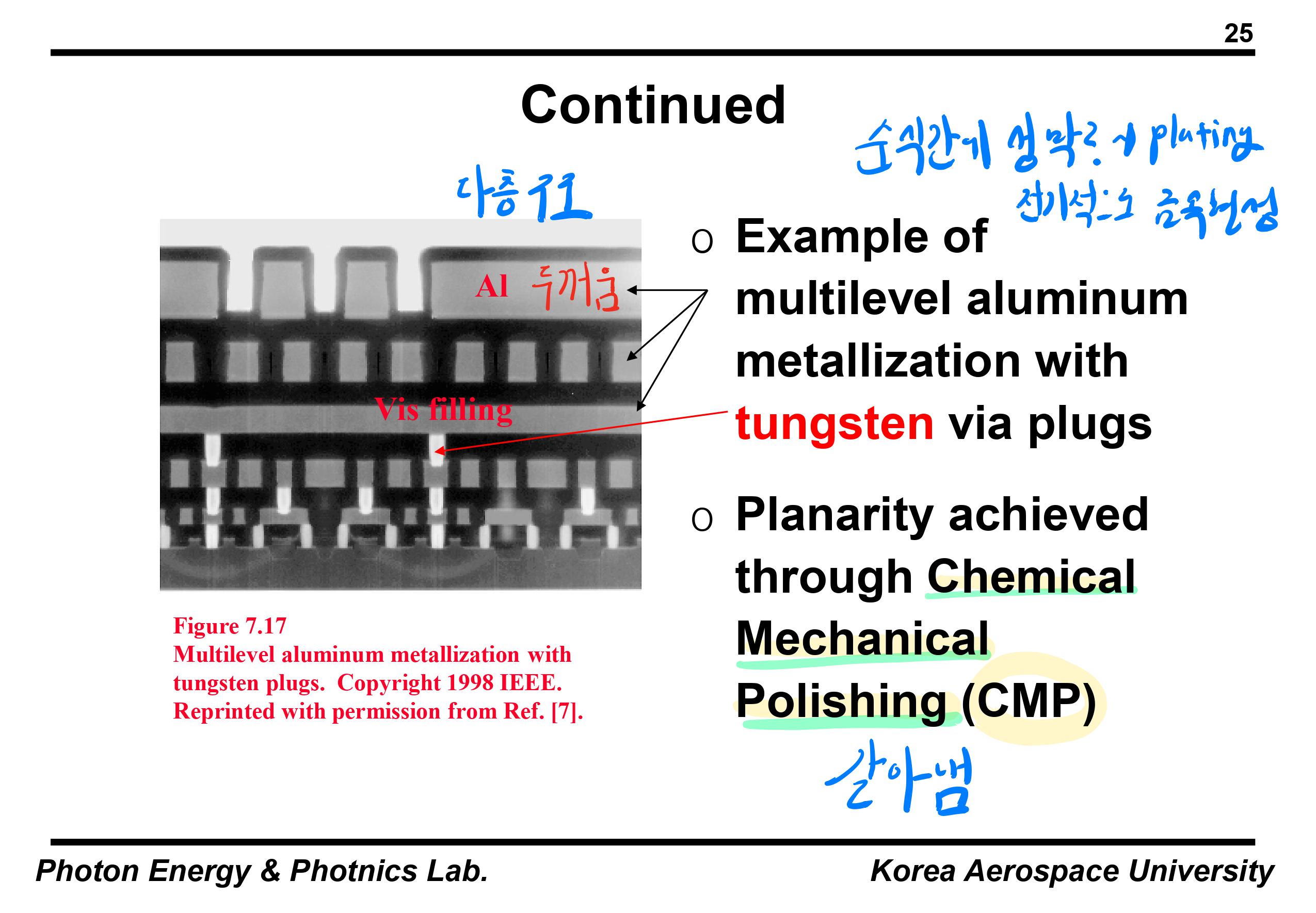
이때 Chemical Mechanical Polishing(CMP)를 통해서 갈아낸다.

구리는 높은 온도에서 공정해야 하기 때문에 Thermal로 쌓기 어렵다.
그렇기 때문에 plating 방법을 이용하는데 구리액에 웨이퍼를 담가서 구리를 적출하는 방식이다.

Seed layer에 전류를 흘려서 해당 부분만 적출한다. 원하지 않는 부분은 Masking material을 놓는다.
적출이 끝나면 마스크 물질을 제거한다.

마스크 물질이 있던 자리는 다시 채워야 하는데 미리 채워두고
그 사이 홈에 금속을 쌓는 방법이 Damascene plating 방법이다.
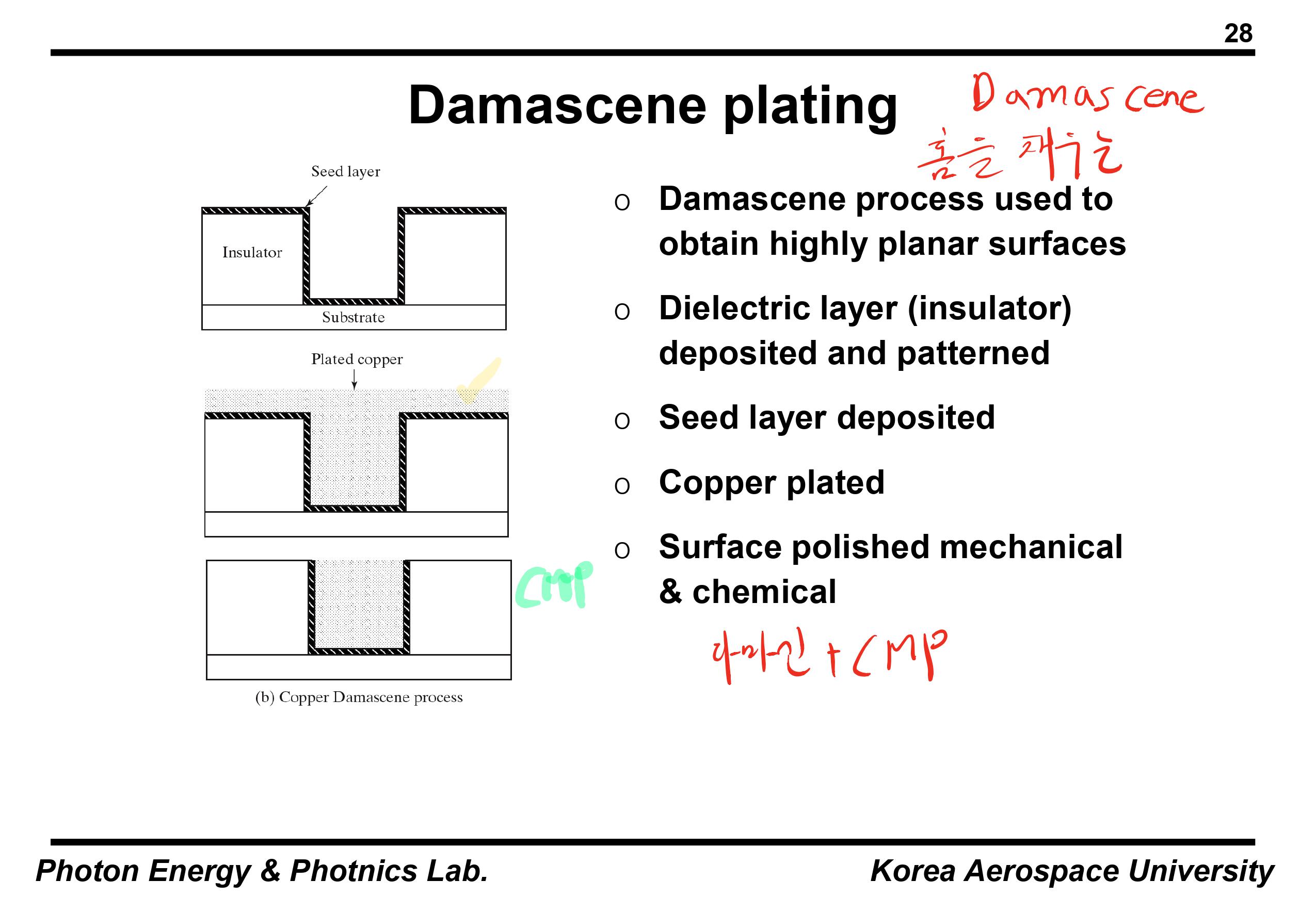
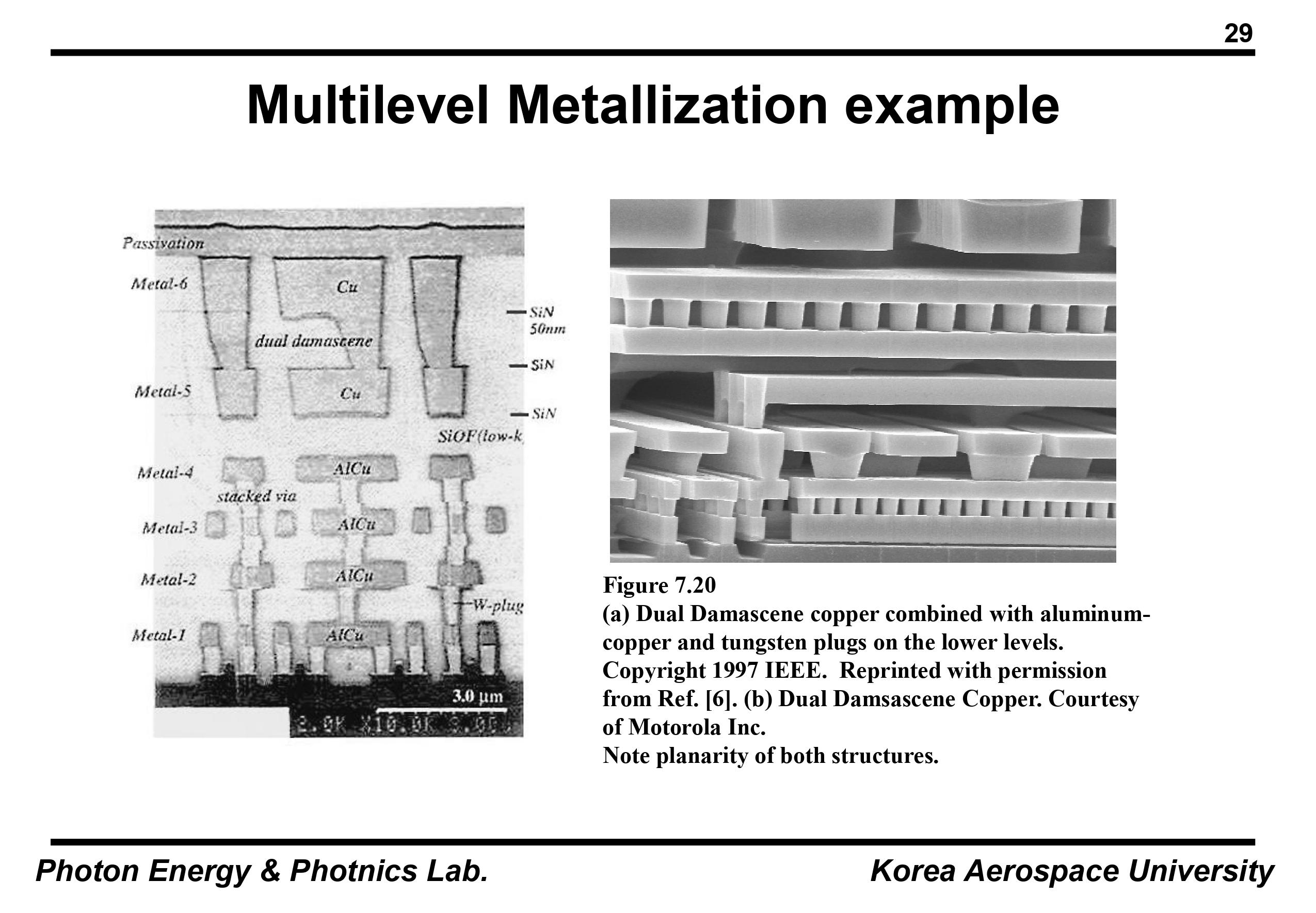
'반도체 이야기 > 반도체공학' 카테고리의 다른 글
| 반도체공학 [MOS Process Integration] [MEMS] (0) | 2021.06.18 |
|---|---|
| 반도체공학 [Packaging and Yield] (0) | 2021.06.18 |
| 반도체공학 [Film Deposition] (0) | 2021.06.15 |
| 반도체공학 [Ion Implantation] (4) | 2021.06.15 |
| 반도체공학 [Diffusion] (1) | 2021.06.14 |